パッケージ洗浄
ゼストロンはフリップチップやCMOS、BGAのようなパッケージ向けに水系・溶剤系の洗浄剤をご提供しております。ゼストロンの洗浄剤は半田バンプリフロー工程のようなボーリングの前工程後、チップと基板間の狭い隙間やキャピラリからフラックス残渣を除去することができます。また、画像解像度を向上させるために、カメラモジュールから条痕やパーティクルを確実になくします。フラックス残渣及びパーティクルの除去により、アンダーフィル材の最適な濡れ性を保ちます。
アンダーフィル前のフリップチップ洗浄フリップチップパッケージ
BGA、PGAやマイクロBGAのようなフリップチップコンポーネントの後工程処理の間、電気接点(バンプ)はコンポーネントベースにリフロー工程によって半田付けされます。
フリップチップ製造の間、ダイアタッチ工程のためにフラックスペースト(粘着性フラックス)がディスペンサーを介して、スプレーもしくはチップディップ工程にて使用されます。
アンダーフィル工程に使われる素材の完全かつボイドのない濡れ性を実現するため、フリップチップと基材の間の狭い隙間にあるフラックス残渣の除去は絶対的に必要です。
洗浄工程の主な要求事項は以下の通りです。
・粘着性フラックスに対して、短時間でも適切にファインピッチ間に浸透する優れた洗浄剤の濡れ性
・部品下部の残渣を完全に除去できる洗浄剤の優れたリンス性
ゼストロンのフリップチップ用に適するよう開発された洗浄工程は、適切なアンダーフィルの濡れ性をもたらし、アンダーフィルのボイドを防ぎます。
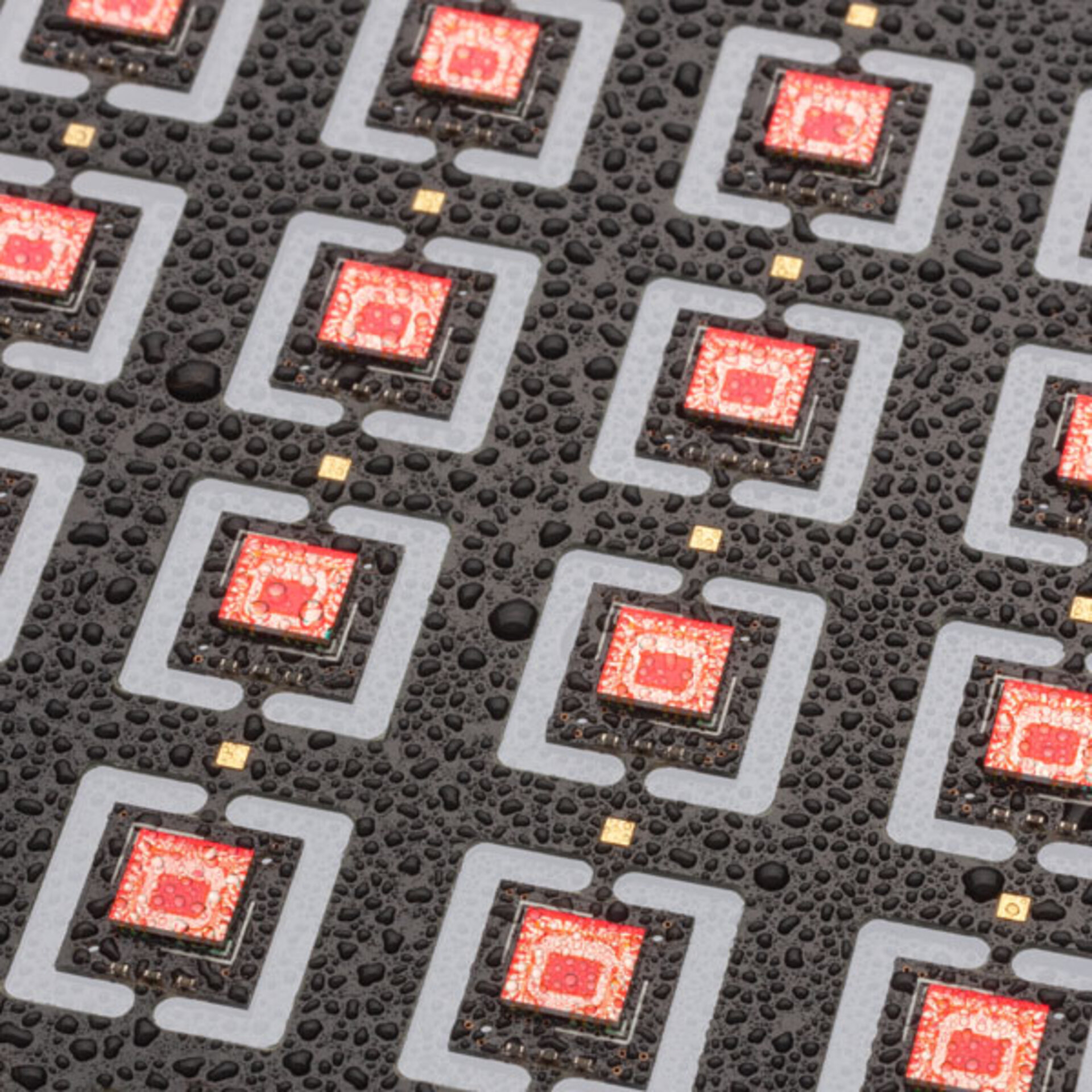
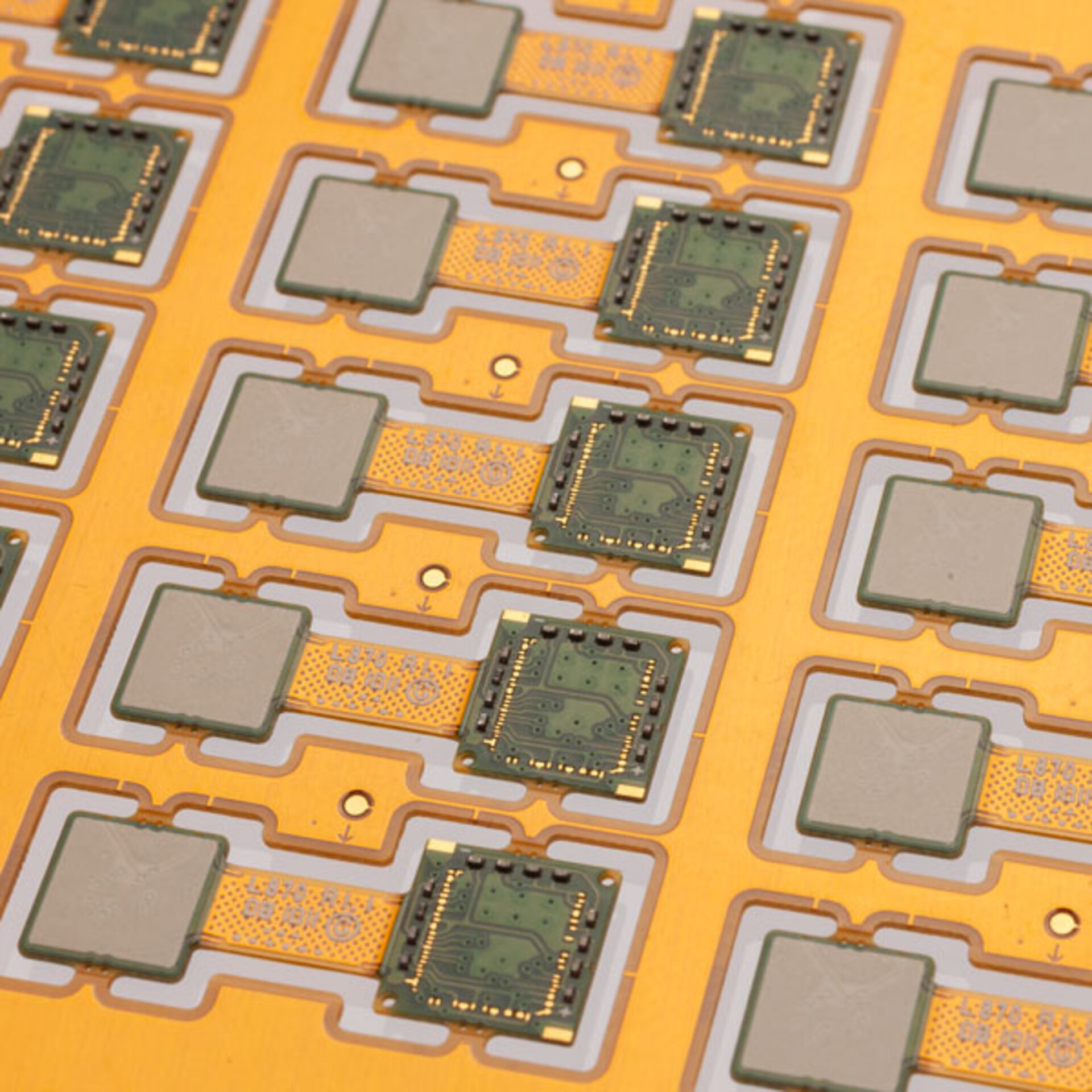
ボイドのないアンダーフィル 残渣のないガラスフィルターのためにCMOS-カメラモジュール洗浄
フリップチップコンポーネントの後工程処理と同様に、CMOSを製造する際、フリップチップまたはBGAベースのイメージセンサはリフロー工程によってベース基板に半田付けされます。ダイアタッチ工程にはフラックスペースト(粘着性フラックス)がディスペンサーを介して、スプレーもしくはチップディップ工程にて使用されます。
結果として、カメラモジュール(CMOS)製造の際の洗浄工程には主に2つの要求事項があります。
・最適な濡れ性(浸透性や洗浄剤のリンス性)により、ファインピッチ仕様からの完全なフラックス残渣の除去
・製造工程において、あらゆるパーティクルの除去
この特定の洗浄用途に使用できるゼストロンの水系・溶剤系の洗浄剤は、狭い隙間への優れた浸透性とリンス性を特徴としています。一方では、最適なフラックス除去とそれに伴うボイドのないアンダーフィルをもたらし、もう一方では、完璧な解像度を確実にし画素欠陥を防ぐため、イメージセンサのガラスフィルターにパーティクルや条痕のないことを保証します。
はんだボール工程後のBGA、マイクロBGA洗浄BGAはんだボール工程後のBGA・マイクロBGA洗浄
BGAやマイクロBGAのボーリング工程の間、外部接続がベースに取り付けられます。通常、作り置きのボールがフラックスペーストを使用してベースに半田付けされます。洗浄工程を導入することでエレクトロケミカルマイグレーションやリーク電流、腐食の危険性が低減されます。

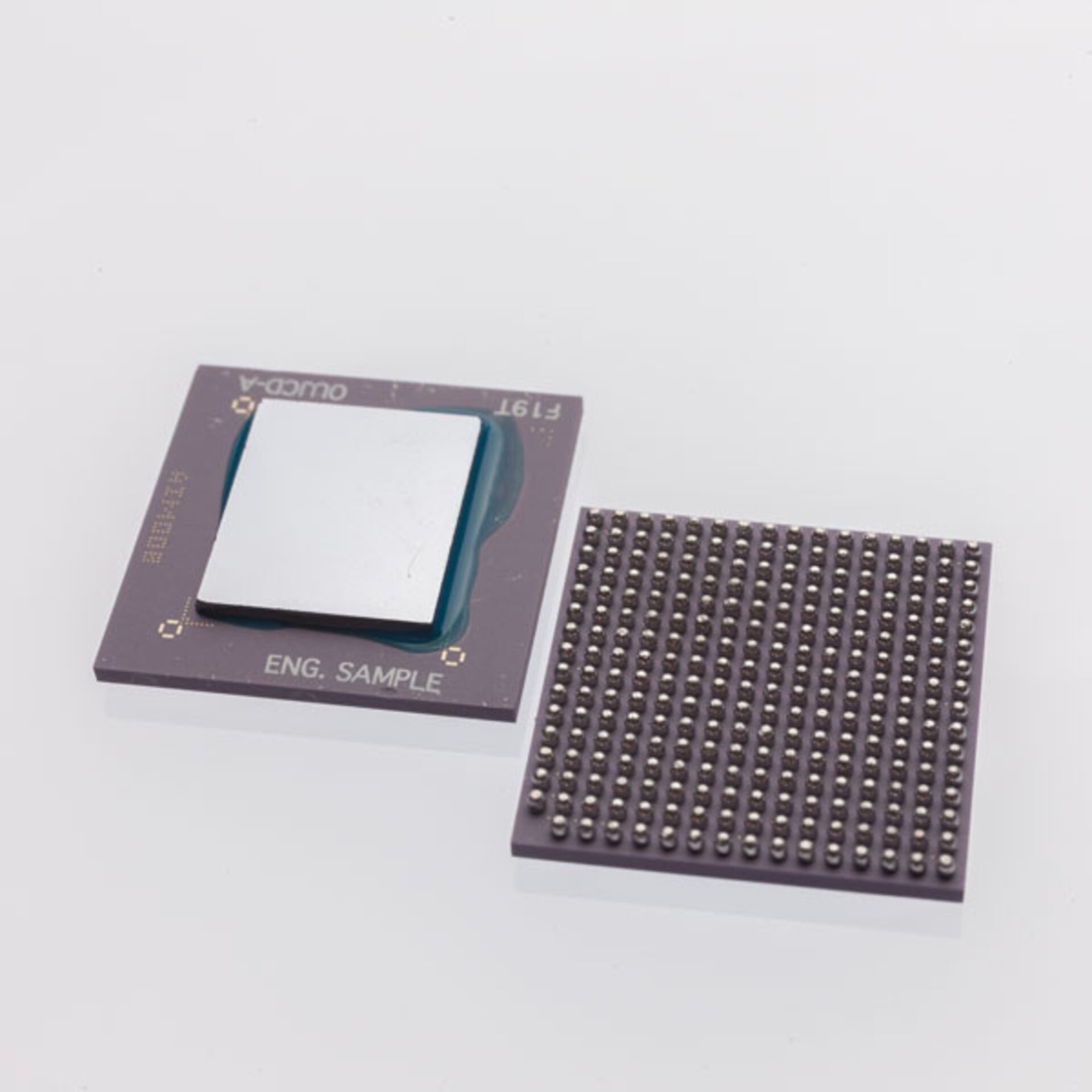
洗浄剤テクノロジーエレクトロニクス製造のための
革新的な技術
ゼストロンは、年間売上高の10%以上を研究開発に投資することで、洗浄技術、分析、洗浄液濃度測定・管理の分野で数多くの製品を開発してきました。洗浄剤テクノロジー技術には、MPC®、HYDRON®、FAST®技術、最新の溶剤などがあります。
無料の洗浄テストで
パッケージ向け洗浄剤をお試しください
Step.1 ご希望に沿った装置(スプレー、超音波、噴流など)にて洗浄テストを実施
Step.2 分析センターにて清浄度を確認
Step.3 洗浄結果を記載したテクニカルレポートのご提供
パッケージ向けの洗浄剤
ゼストロンでは約40種類以上の洗浄剤をご用意しております。
お客様のニーズに合った洗浄剤を下記のフィルターよりお探しください。


